采用 TSMC InFO_LI 封装的 Apple M1 Ultra 芯片
随着 Mac Studio 的发布,Apple 推出了 M1 Ultra,这是 M1 系列中最强大的芯片。通过名为 UltraFusion 的封装架构,Apple 将两个 M1 Max 芯片互连,将 Apple 芯片扩展到前所未有的新高度,赋予 Mac Studio 令人难以置信的计算能力。
M1 Ultra由1140亿个晶体管组成,配置最高128GB高带宽(最高800GB/s)、低延迟统一内存,外加最高20核CPU(16个性能核心+4个能效核心)、64核GPU 和 32 核 NPU。每个性能核心有192KB指令缓存、128KB数据缓存、总共48MB二级缓存,每个能效核心有128KB指令缓存、64KB数据缓存、总共8MB二级缓存。UltraFusion 封装架构的中介层具有超过 10,000 个信号引脚,并在处理器之间提供 2.5 TB/s 的低延迟带宽。
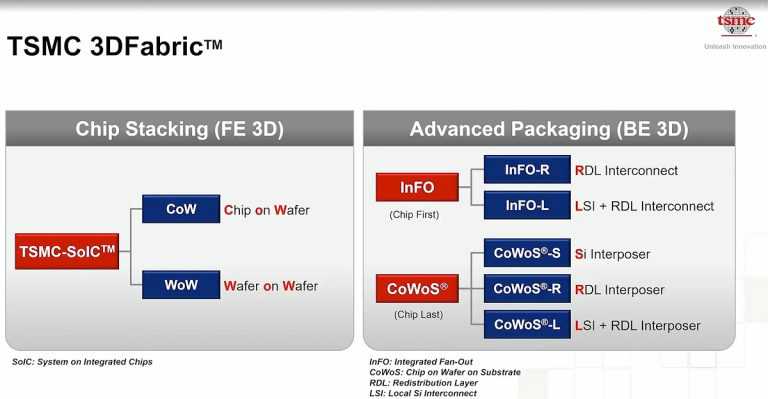
人们普遍认为 Apple 的 UltraFusion 封装架构基于 TSMC 的 CoWoS(Chip-on-Wafer-on-Substrate),这是一种 2.5D封装技术,可将多个小芯片封装到单个基板上。不过,半导体封装专业人士 Tom Wassick 放出相关幻灯片显示,M1 Ultra 采用了台积电称为“InFO_LI”的封装方式,这是一种用于本地芯片互连的晶圆级封装。
虽然 CoWoS 已经被许多设计厂商验证并采用,但 InFO_LI 的成本相对较低。抛开成本因素,苹果并没有选择 CoWoS,因为 M1 Ultra 只需要互连两个 M1 Max 芯片,包括内存和 GPU,它们已经是芯片的一部分,不需要其他组件。除非苹果采用多芯片设计或拥有更快的 HBM 内存,否则没有必要选择更昂贵的 CoWoS。
- 上一篇

Meta确认将于6月3日关闭其Facebook播客服务
FacebookPodcast服务于去年6月下旬推出,此前已被Meta确认将于6月3日结束,本周开始将不再向创作者开放上传新内容。据彭博社报道,Meta表示已经结束了FacebookPodcast服务,主要是希望将其资源集中在更有意义的...
- 下一篇

Google 新版 Google Travel 让您更轻松地计划下一次旅行
随着美国逐渐从大流行中复苏,旅游业显然将成为下一个准备复苏的行业,谷歌宣布提前更新其与旅行相关的服务,如谷歌航班,让用户更容易通过互联网规划未来长达六个月的每月旅行计划。在新版谷歌航班中,谷歌将允许用户在未来...
相关文章
- 新安装的win10系统桌面如何显示这个电脑图标
- 如何在 Windows 10 或 Windows 11 上使用 Apple Notes
- 电脑浏览器主页被篡改?如何恢复安装的ghost win7系统ie主页被篡改
- 安装的ghost win7文件夹属性没有安全选项
- 最新的 Apple 过时和停产产品目录已发布
- Apple Watch Series 8 没有血压计
- 三星将推出采用 LG 面板的 OLED 电视
- Apple 通过 Apple Pay 交易向世界自然基金会捐款以响应地球日
- 有人在旧 Apple 硬件上安装了 Windows 11
- Apple MagSafe Battery Pack 新固件支持 7.5W 无线充电
